RIEでエッチングしているとき,加工物の一部が帯電するとそれによってイオンの軌跡が曲げられてしまい,正しい形状にエッチングできなくなる。
Deep RIEで深い溝を作るとき,チャージアップによってイオンが曲げられてしまい,正しい形状が得られないことがある(図1)。
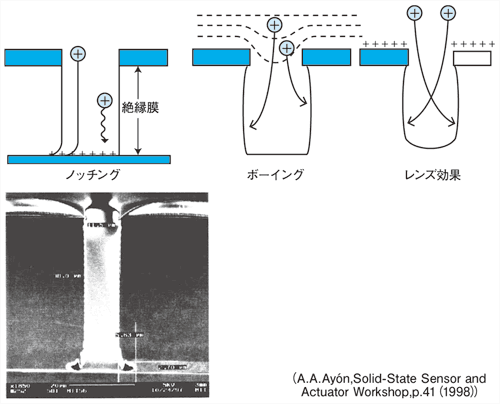
Siをエッチングしたときに酸化シリコンなどの絶縁膜が現れる構造では,溝の底の絶縁膜表面がチャージアップすることで,イオンは曲げられて,側壁の下の部分がエッチングされる。これをノッチングという。また,表面が絶縁物になっていても,チャージアップが発生し,イオンの軌跡に影響を与えて,ボーイングと呼ばれる変形が発生する。
この問題は,パルス・プラズマを使うことでかなり解決できるようになった。プラズマを起こした後に少し休止すると,電子が中性の粒子に付いてネガティブ・イオンができる。このネガティブ・イオンがチャージアップした部分を中和するという技術である。なお,溝の底部に金属の層を形成しておける場合には,チャージアップを防ぐことができる。
イオンではなくて中性の原子を使う方法もある。図2は,かつて荏原製作所が作っていた高速原子線エッチング(FAB:fast atomic beam)装置だが,FやCl,酸素のイオンを放電させて加速し,炭素陰極の穴をすり抜けるときに電子をもらって中性になって出てくるというもの。基板にぶつかるときにはイオンではないので,チャージアップがあっても曲げられない。右の写真は,この装置で幅0.1μm,深さ1μmの溝を作った例である。
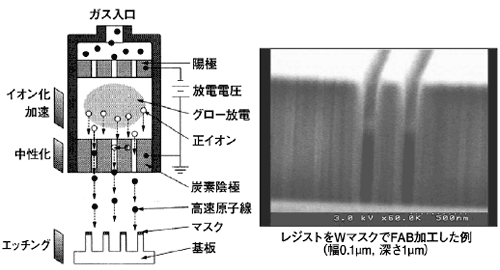
東北大学の寒川誠二教授も半導体プロセスのダメージ・フリーを目的に, ICP(inductively coupled plasma)という誘導結合プラズマで高密度プラズマを作り,パルス駆動で発生したネガティブ・イオンを中性にして基板に当てるという中性粒子ビーム・エッチング装置を開発している。エッチング・レートが速いのが特徴である。



















































