エッチングにはウェット・プロセスとドライ・プロセスがあり,それぞれに等方性エッチングと異方性エッチングがある。
エッチングは,MEMSを作る基本的で重要な技術である。エッチングはマスク材料と下地材料のエッチング速度の違いを利用する。このため,実際のMEMS製造プロセスではさまざまな材料を組み合わせて使う。
エッチングするときに,レジストをそのままマスクにできればよいのだが,エッチング液やエッチング・ガスによって有機物のレジストがやられてしまう場合が多い。そういうときは,いったん下地(Si基板)の上に例えばSiO2層を作り,それをレジストでパターニングして,そのSiO2パターンをマスクにする。
エッチングには液体を使うウエット・エッチングと,反応性のガスを使うドライ・エッチングがある。それぞれ,等方性エッチングと異方性エッチングの2種類がある(図1)。
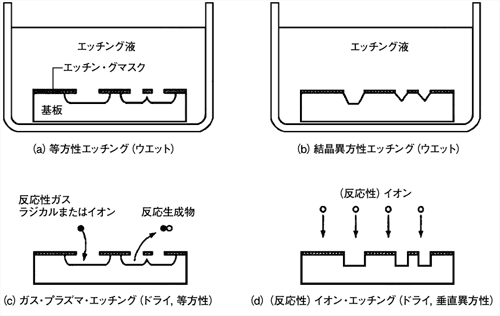
等方性エッチングは,マスクの窓から下の方だけでなく,横の方も同じ速度でエッチングされるためマスクの直下がえぐられていく。犠牲層を取り去るときにはこの方法を使う。
異方性エッチングは,ある方向にだけエッチングしたいときに使う。ウエット・エッチングでは,エッチング速度の結晶異方性を利用する。ドライ・エッチングの場合は,垂直にイオンをぶつけて,垂直方向だけをエッチングする。



















































