ひずみを制御してLSI特性を高めるために,ひずみ測定技術への期待が高まっている。背景には,微細化の進展だけでなく,ひずみSi技術などの新たな技術の導入がある。連載の第5回は,LSI分野で主流のラマン分光法を使ったひずみ(応力)の測定原理と測定手法を解説するとともに,既存のラマン分光法の限界を打ち破る近接場光技術の最新開発状況を紹介する。
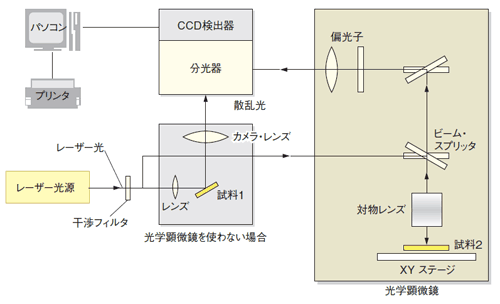
吉川 正信
東レリサーチセンター
構造化学研究部
中島 信一
大阪大学
名誉教授
LSIの製造時には,インゴット形成,ウエーハ形成,回路形成,パッケージ形成のすべての工程で,さまざまなひずみ(応力)が発生する。こうしたひずみを測定・評価する手法として,「顕微ラマン分光法」が半導体分野で広く利用されてきた。現在では評価技術の一つとして定着している。
しかし,LSIの微細化に伴い,特に回路形成過程で発生するひずみの測定において,既存の測定装置の空間分解能500nmでは不十分になってきた(図1)。例えばトランジスタのチャネル部分に応力が加わるようにしてSiの結晶格子をひずませるひずみSi技術を使う場合には,ひずみの微妙な制御が欠かせない。微小なひずみの検出には,最低でも100nm程度の空間分解能が必要になる。現状では,ウエーハ上に薄膜を形成してひずみを測定した結果と,シミュレーションの結果を合わせて,実デバイスに加わるひずみを予測している。
このような要求に対して期待を集めているのが,顕微ラマン分光法で近接場光を利用する手法である。50~100nmの空間分解能を実現できる可能性が高い。われわれも現在開発中であり,2008年4月以降に受託分析を始められるように準備を進めている。今後,近接場光あるいは極短波長励起光を利用した高空間分解能ラマン分光装置の開発が進めば,高精度にひずみを測定・制御できるようになり,LSIのさらなる性能向上に大きく貢献するだろう。
本稿では,顕微ラマン分光法の原理を解説した上で,われわれが開発を進める近接場光を利用した高空間分解能ラマン分光法を紹介する。




















































