第3回で紹介したフォトマスク技術と同様に,リソグラフィの進化を支えてきたのがフォト・レジストである。レジスト・メーカーは,露光光源の短波長化への対応に加えて,純水とレジストが接する液浸露光の導入に伴う課題に対応してきた。さらに,ダブル・パターニングやEUV(extreme ultraviolet)露光といった次世代リソグラフィ技術でも,レジストが成否のカギを握る。第4回は,こうしたレジスト技術の動向を解説する。
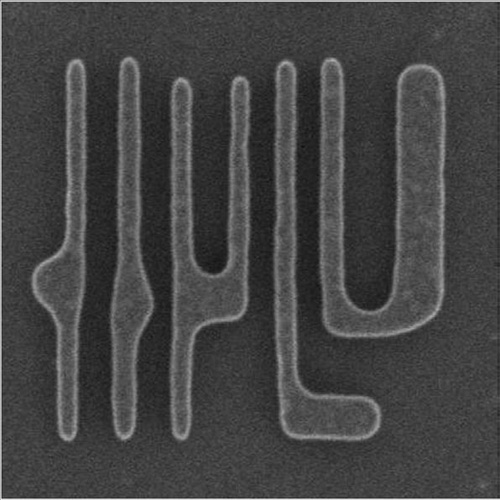
島 基之
JSR
電子材料事業部 電子材料第一部
フォト・レジスト(レジスト)は,リソグラフィ工程で使われる感光性樹脂であり,半導体デバイスの微細化を支える材料である。レジストはこれまで,微細化に向けた露光装置の光源の短波長化や,新しいリソグラフィ・プロセスの導入に対応してきた(図1)。現在では,液浸露光技術により,ハーフ・ピッチ40nmのパターンを形成できる段階に至っている。ダブル・パターニングやEUV(extreme ultra-violet)露光といった,次世代リソグラフィ技術に対応するレジストの開発も着実に進んでいる。本稿では,こうしたレジスト技術の進化と,その過程で乗り越えてきた課題について紹介する。ここでは,g線以降の標準技術のポジ・レジストに焦点を当てる。




















































