材料ガスを熱やプラズマで分解し,基板表面に堆積させる成膜法。表面反応を利用するときわめて被覆性のよい膜が形成できる。
CVDは,蒸気圧のある材料をガスの状態で反応槽に供給し,何らかのエネルギーを与えて分解・反応させ,基板の表面に膜を堆積する技術である(図1)。
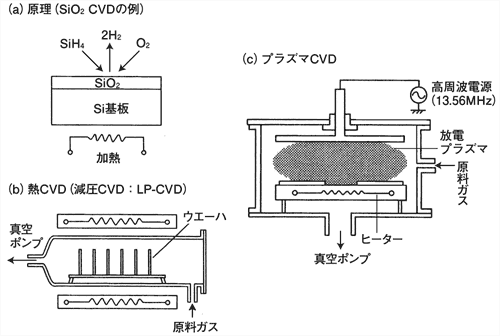
熱CVDは,原料ガスを熱で分解し成膜する。例えば,シラン(SiH4)を熱分解させると多結晶Siになる。このとき,酸素雰囲気で分解させれば SiO2ができる。
普通の熱CVDでは,ガスの供給が多い場所と少ない場所で,厚さが不均一になる。減圧CVD(LPCVD)という方法を使うと,分子の平均自由行程が延びて,分子が拡散しやすくなり,膜厚の均一性が高まる。
熱エネルギーの代わりに高周波のエネルギーを使うと,低温で成膜できる。これをプラズマCVDという。基板と対向する電極に高周波をかけて放電させ,原料ガスを分解して成膜する。
タングステンの選択CVD
W(タングステン)の選択CVDは半導体プロセスでもよく使われるが,これをMEMSに使った例もある。
Si基板上の酸化膜の表面に窒化Siを付けて,RIEで溝を作っておく。これにSiをイオン注入し窒化Siを除去すると,溝の底のSiO2の表面にSiが注入される。この状態で六フッ化タングステン(WF6)のガスでCVDを行うと,Siが触媒になって表面反応が起こり,Wが堆積する。
溝の底からWが成長していき,溝の中だけに選択的にWが埋め込まれる。最後にSiO2を取り去ることで,Wでできた構造体を作ることができる。米Cornell大学は,この技術でWの電子線源や静電レンズを作り込んだMEMSの電子銃を試作している。
高い表面被覆性
反応種が表面に吸着して膜を作る条件でCVDを行うと,凹凸や溝など立体的な構造の表面をきれいに被覆してくれる。
例えば,基板に穴を開け,貫通配線で基板の裏側まで金属膜を付けようというような場合,CVDなら多少,段差があっても表面を覆って配線がつながる。



















































