さまざまな材料を組み合わせて作るMEMSでは,膜に働く応力で壊れてしまうことがある。
MEMSの場合には膜を厚く付けることが多く,膜の応力コントロールが問題になる。応力をきちんとコントロールしないと,割れたり,反ったり,はがれたりということが起こる。例えば,付着力が弱い所に引っ張り応力がかかると,めくれてはがれてしまう。付着力が強いとはがれないが,代わりに反りが発生する。蒸着でもスパッタリングでもCVDでも,常に応力のコントロールを考えながら成膜することが重要である。
応力には2つあり,1つは熱応力である。例えば,金属を蒸着で付けるときは基板の温度が上がる。温度が下がると,金属は熱膨張係数が大きいので,基板より金属膜の方が縮んだ状態になる。そうすると,金属膜には引っ張り応力がかかる。
もう1つは,内部応力である。スパッタリングの場合,Arなどの雰囲気ガスが膜の中に吸蔵され,後でガスを放出することで収縮し引っ張り応力が生じる。ガスの種類や圧力によって,スパッタリング膜の内部応力は変わる。Arの代わりにKr(クリプトン)のような重い原子を使うと,膜の中に入りにくく,後から縮むことが少ないという報告もある。スパッタリング時の圧力が低いと圧縮応力になる。
図1は,Siの板をエッチングして片持ち梁(はり)を作った例である。左の写真は,Siの板をバルクから削り出して作ったもので,全くひずみがない。長さは500μmぐらいあるが,1μmも反っていない。右の写真はSiを熱酸化し,下のSiを取って上の熱酸化膜だけを残したものである。この場合は,しわが寄ってしまう。さらに,この応力のために崩壊してしまうこともある。
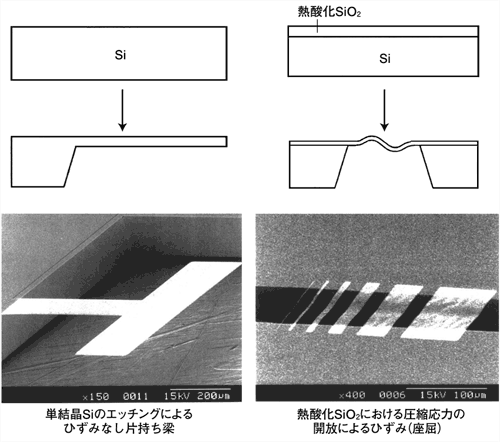
SiO2の熱膨張率は0.3ppm/℃なのに対し,Siの熱膨張率は3ppm/℃であり, SiO2の方が熱膨張率が約1ケタ小さい。1000℃で熱酸化して温度が下がってくると,SiO2はほとんど縮まず,Siの方は大きく縮む。従ってSiO2には圧縮応力がかかっており,下のSiを溶かして除去するとそれが解放され,右の写真のように座屈する。



















































