ガラスはMEMSを構成する重要な材料だが,エッチング・レートが非常に遅いという問題がある。
ガラス基板を使ったウエーハ・レベル・パッケージングでは,ガラスに細い穴を開けて配線を取り出すような加工が必要である。しかし,一般にガラスは穴が開けにくい材料として知られている。ガラスは結晶ではないので,結晶異方性エッチングが使えないためである。ウエット・エッチングでは等方性になってしまう。仮に,厚さ500μmのガラス板に直径100μmの穴を開けようと思っても,深さ方向に500μm掘ると必ず横にも500μm入るので,1mmぐらいの穴が開いてしまう。
図1は,私たちが開発したガラスや水晶を加工するためのDeep RIEの装置である。ICPによる高密度プラズマ装置とマグネトロンRIEが一緒になったような装置である。
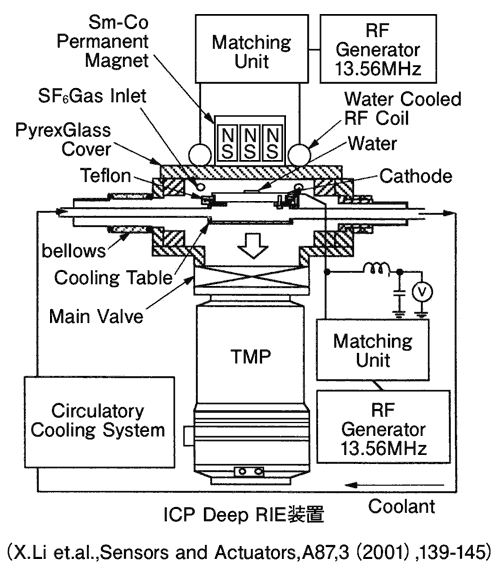
エッチング・レートを上げるには反応生成物をどんどん捨ててしまえばよいという考えに基づいて,小さなチャンバに大型のターボ分子ポンプを付けている。また,基板バイアスを高めに設定してあるため,イオンが基板を物理的にたたくので,マスクもやられる。しかし,マスクにはNiのメッキ膜とか,SU-8のような厚いレジストを使えばいいという考え方で,いわば無理やりガラスをエッチングする。それでも0.5μm/分しかエッチングできない。ちなみに,Siだと10μm/分ぐらいで削れる。
ガラスには,エッチング・レートが遅いという大きな問題がある。0.5μm/分というと,100分間エッチングしても深さがやっと50μmである。 6インチウエーハの場合,直径15cmで厚さ50μmの薄いガラスをハンドリングすることは不可能である。そこで,次のようなテクニックを使う(図2)。
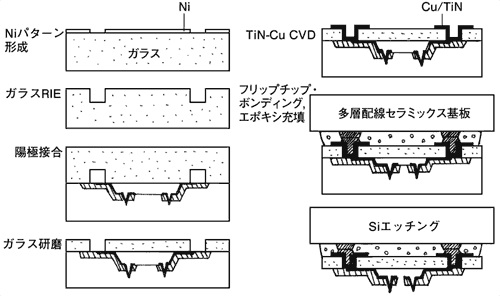
まず,ガラス基板にNiメッキで厚いマスクを形成し,先ほどのDeep RIEで50μmの穴を開ける。これを裏返して,加工済みのSi基板に位置合わせをしながら陽極接合する。そして,ガラス基板を裏側から研磨していく。Si基板と接合してあるので,ガラスはいくら薄く研磨しても割れない。その後,表面被覆性の良いCVDでCuの電極を形成し,多層セラミック基板にフリップチップ・ポンディングする。最後に,Siの不純物濃度依存性エッチングを行うことで,LSIテスト用のコンタクタができる。



















































