ドライ・エッチングでは,CF4やXeF2を分解して生成したFラジカルを使うと,Siの等方性エッチングができる。
ドライ・エッチングの等方性エッチングは,プラズマや反応性ガスを使って行う。プラズマ・エッチングの場合は,例えばCF4のガスからFラジカルを作り,Si基板をエッチングする(図1)。
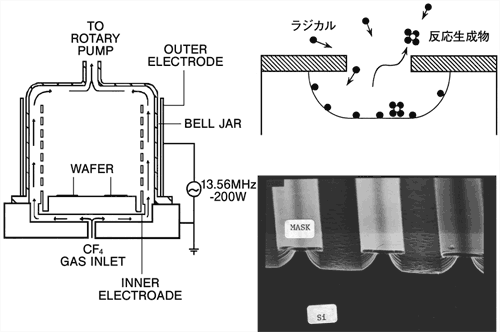
プラズマを使わずに, XeF2のような反応性ガスを使っても等方性エッチングはできる。 XeF2が分解してFラジカルができ,Siと反応してSiF4を作り,それが蒸発していく。
XeF2によるSiのエッチングは,SiO2やフォトレジスト,Al,Crなどのマスクに対して選択性が1000以上と非常に高い。Si3N4(窒化シリコン)に対してもかなり高い選択性がある。Ti,Nb,Moなどに関しては選択性が悪く,W,Ir,Au,Ag,Taなどはエッチングされてしまう。
XeF2以外にもSiのガス・エッチングに使える材料として,ClF3,BrF3,F2などが報告されている。
図2は,XeF2の等方性エッチングで作った振動ジャイロの例である。重りをSiのバネで支えて,横方向に静電引力で振動させる。センサーが回転すると,コリオリの力で上下の振動成分が出てくるので,それを静電容量の変化として検出する。
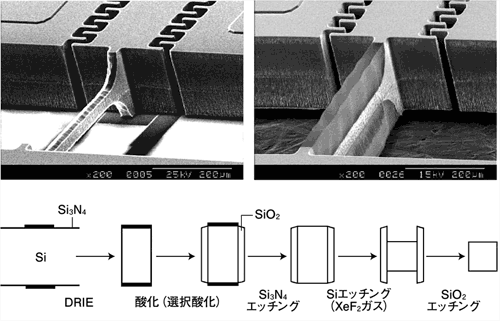
このバネの幅と厚さをコントロールして,共振周波数を制御するのが課題だった。プロセスとしては,まずSi3N4をマスクにしてRIE(反応性イオン・エッチング)で打ち抜き,選択酸化する。Si3N4の所は酸化されず側面だけが酸化される。LSIの素子分離に使われるLOCOSというプロセスと同じである。次に,上下のSi3N4を取ってXeF2でエッチングして,ある厚さになったら止める。そこで側面のSiO2を取ると,Siのバネの幅と厚さがコントロールできる。



















































