半導体加工技術を使ってMEMSを構成する構造体やセンサー,アクチュエータなどを作る手法。Si基板に深い溝や梁など複雑な立体構造を作る。
マイクロマシニングは大きく2つに分けられる。1つは表面マイクロマシニング,もう1つはバルク・マイクロマシニングである。
表面マイクロマシニングは,米Anolog Devices社の加速度センサーや米Texas Instruments(TI)社のDMD(digital micromirror device)などに使われている技術で,両方とも電子回路を載せた集積化MEMSである。
犠牲層というものを形成して,その上に構造体を作り,後でこの犠牲層を取り去ることで,梁のように宙に浮いた構造体を作る(図1)。ちょうつがいを作ってやれば,図1のように立てることもできる。表面マイクロマシニングで作った構造体は比較的壊れにくいのだが,構造体が別の構造体や基板に張り付いてしまうという問題がある。
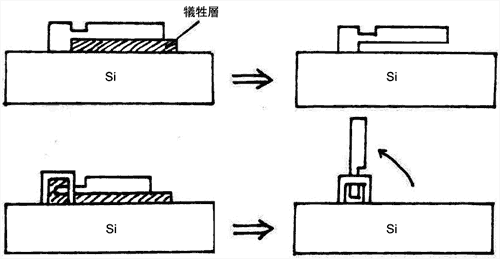
バルク・マイクロマシニングでは,結晶異方性エッチングやRIE(reactive ion etching)などの技術でSiを深く削り,圧力センサーに使う薄いダイヤフラムや,加速度センサーに使う重りをバネで支えた構造などを作る。薄いダイヤフラムは不純物濃度異方性エッチングで作ることもできる。さらに,陽極接合という技術でガラスとSiを張り合わせるのも,バルク・マイクロマシニングの特徴である(図2)。
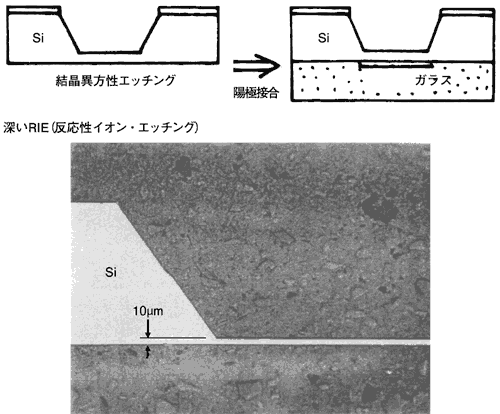
バルク・マイクロマシニングでは,張り付きの問題は比較的ない。ただし,作っているときに壊れるのが問題である。微細な構造体は,水から出すだけで水の表面張力によって壊れることがある。



















































