Si ウエーハの端面および周辺の傾斜部をベベルと呼ぶ。このベベルに対応するプロセス装置や検査装置が相次いで登場している。ベベルの異物や膜の除去装置を,大日本スクリーン製造が2006 年10 月に,東京精密が11 月にそれぞれ発売した。これに続き,米KLA-Tencor Corp.が,ベベルの異物や欠陥を検出するウエーハ検査装置を開発し,2007 年第1 四半期に大手LSI メーカー向けに出荷を開始する(図1)。
新材料や液浸露光で歩留まりに影響
こうした装置の製品化が相次いでいるのは,LSI への新材料や新プロセスの導入に伴って,ベベルの異物や欠陥が歩留まりに与える影響が顕著になるためである。例えば,低誘電率(low-k)膜のような強度の低い材料は,ウエーハ端に大きな圧力が加わる搬送工程で,はがれを生じやすい。こうした異物は,液浸露光の際にレンズ直下の液体を介してウエーハ端から中心付近へと移動し,歩留まりを低下させる。デバイスへの影響だけではなく,異物が露光装置のレンズに付着して,装置の故障を引き起こす危険性もある。このため,ベベルの異物や欠陥を早期に検出し,その要因を特定することが,歩留まり改善に欠かせなくなってきた。
こうした状況を受けて,大日本スクリーン製造はベベルの異物を純水によるブラシ洗浄技術を使って除去する洗浄装置を製品化した。東京精密の膜除去装置は,従来のプラズマや薬液によるエッチングの代わりにガスによる化学分解反応を利用する。KLA-Tencorの検査装置は,立体的なベベルの形状に合わせてレーザーを走査できる。これによって,ウエーハ表面だけでなく裏面のベベルの検査も可能にしている。
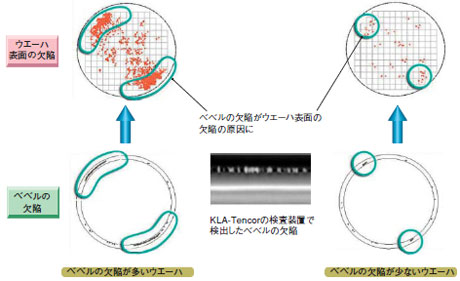
図1 ベベルの異物や欠陥がLSI の歩留まりを低下させる
低誘電率(low-k)膜などの新材料や液浸露光といった新プロセスの導入に伴って,ベベルの異物や欠陥がLSIの歩留まりに大きな影響を与えるようになった。ベベルで生じた異物や欠陥は,液浸露光の際に使う純水などを介してウエーハの中心付近へと移動する。米KLATencor Corp.のデータを基に本誌が作成。



















































