製造バラつきがあっても確実に動作する新構造のトランジスタを開発する国家プロジェクトがスタートした。2006年度から始まった半導体MIRAIプロジェクトの新プログラム「ロバスト・トランジスタ」である。バラつきの問題に対しては,これまで回路レイアウトの工夫などで対策する,a href="/article/WORD/20060830/120601/">DFM(design for manufacturability)の取り組みが多かったが,今回のロバスト・トランジスタではデバイスやプロセスそのものを見直す。バラつきを引き起こしている物理的な原因を定量的に解析するほか,バラつきに対して強いトランジスタ構造を見いだす(図1)。
物理パラメータを正確かつ高速に評価
バラつきの原因に関しては,これまで定性的には分かっていたが,定量的な解析は十分ではなかった。バラつきの原因にはゲート長やゲート絶縁膜厚,不純物濃度といった複数の物理パラメータが関係していることに加え,それらの正確な値を複数のトランジスタにわたって統計的に調べることが難しいためである。例えば,ゲート絶縁膜厚一つを取っても,トランジスタごとの値は断面TEM(透過型電子顕微鏡)やAFM(原子間力顕微鏡)で調べないと分からない。そこで,MIRAIでは,物理パラメータの正確かつ高速な測定手法を確立すると共に,電気的な特性バラつきを評価するためのTEG(test element group)を設計し,物理パラメータと電気特性のバラつきの関係を数式化する。この情報を回路設計に生かす。
最終的には,物理パラメータのバラつきを抑制するプロセス技術や,バラつきに強いトランジスタ構造を提案する。現在,想定しているのは「完全空乏型のSOI(silicon on insulator)を使ったトランジスタ」(東京大学教授でロバスト・トランジスタ開発の指揮を執る平本俊郎氏)である。しきい電圧を不純物濃度で制御するのではなく,Si層の厚さやゲートの仕事関数といった別の物理パラメータで制御することで,不純物濃度のバラつきの影響を少なくする。
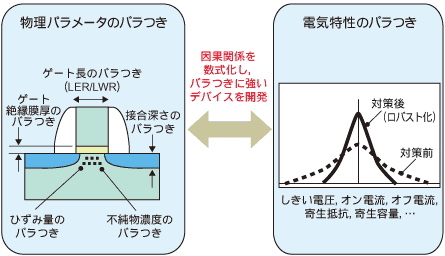
図1 バラつきの因果関係を数式化
物理パラメータと電気特性のバラつきの関係を定量的に解析することによって,バラつきの情報をSPICE(simulation program with integrated circuit emphasis)モデルの中に盛り込むことが可能になる。将来はバラつきそのものに強いトランジスタ構造を提案する。本誌が作成。



















































