90nm以降,新材料や新プロセスを導入することで,微細化だけに頼らずMOS FETの性能を高める動きが活発化してきた。その代表例が,ひずみSiやポーラス低誘電率(low-k)膜,高誘電率(high-k)ゲート絶縁膜/メタル・ゲートである。これらの新材料や新プロセスの採用に伴って,それに対応する計測技術が求められるようになった。その強力な手段が,連載の最終回となる本稿で紹介するX線計測技術である。同技術は,従来の光学式測定に代わって,新材料向けの標準的な計測技術になりつつある。
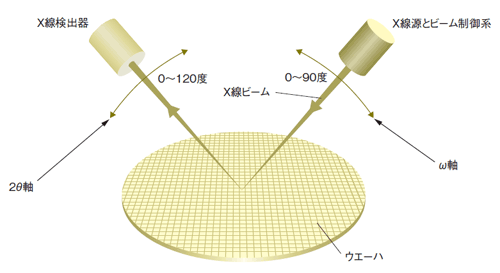
Paul Ryan
英Bede Scientific Instruments Ltd.
「Mooreの法則」は,これまでリソグラフィ技術の進展によるMOS FETの微細化によって維持されてきた。ところが,90nm以降,既存材料の物理限界が近付いたために,微細化だけでMooreの法則を維持することが難しくなった。そこで,集積度と性能の向上を持続するために,新しい材料やプロセスが相次いで導入され始めた。新材料では高誘電率(high-k)ゲート絶縁膜/メタル・ゲートやポーラス低誘電率(low-k)膜,新プロセスではひずみSiなどである。
そこで,LSIの開発と製造において,これらの材料やプロセスに対応する新しい検査・解析技術が必要になってきた。そのための強力なツールとなるのが,本稿で紹介するX線計測技術である(図1)。従来,LSIのインラインの薄膜計測手法は光学式が主流だったが,ここに来てX線計測技術が広く使われるようになっている。特に,ひずみSi技術が90nmで採用されたことをキッカケに,65~45nmの新材料や薄膜の計測にX線が活用され始めている。
本稿では,(1)ひずみSi向けSiGe膜,(2)ポーラスlow-k膜に向けたX線計測技術の応用事例を解説する。いずれも45nm以降に向けて重要性が高まっている新材料,新プロセスを対象としている。これらに加えて,無線周波デバイスや光通信デバイス向けで開発が盛んな(3)HBT(heterojunction bipolar transistor)向けSi/SiGe膜への応用を紹介する。




















































