65~45nm世代のLSI配線工程で導入されるポーラス低誘電率(low-k)膜には,検査・解析技術が欠かせない。ポーラスlow-k膜は,SiO2ベースの絶縁膜に空孔を多く設けて比誘電率(k値)を下げた材料であり,機械的強度やほかの膜との密着性が90nm以前の非ポーラス材料に比べて劣る。そこで,応力や衝撃が加わりやすい配線工程や実装工程に対する信頼性の評価が欠かせない。さらに,配線材料として標準的に使われるCuの解析技術も重要である。これらの評価結果を配線と実装のプロセス構築に反映することで,65~45nmの製造歩留まりを高められる。
川本 佳史
次世代半導体材料技術研究組合(CASMAT)
理事 研究部長
65~45nm以降,LSIの配線工程の検査・解析技術の重要性が高まる。その最大の要因は,LSIの動作速度の向上と消費電力の低減を目的として,メタル配線間を絶縁する層間絶縁膜の材料が変わることにある。具体的には,ポーラス低誘電率(low-k)膜と呼ばれる機械的強度の低いSiO2ベースの絶縁膜が採用される(図1)。ポーラスlow-k膜は,直径が1nm程度の空孔(ポア)を絶縁膜に多数導入し,比誘電率(k値)を下げた材料である(図2)。90nm世代までは,SiO2をベースとし,F原子やCH3基を導入してk値を下げた非ポーラスlow-k材料が使われてきた。
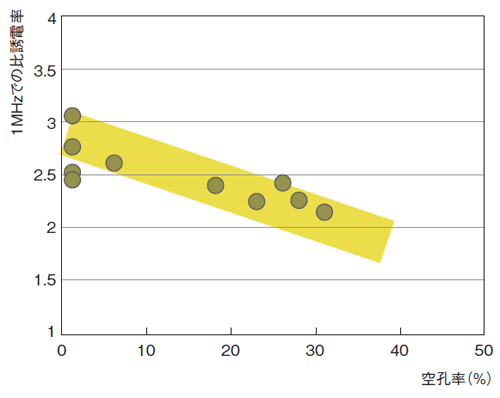
ポーラスlow-k膜は多くの空孔を含むために,LSI製造プロセスにおける信頼性が非ポーラスlow-k材料に比べて劣る。具体的には,弾性率が低いために応力に弱い,ほかの膜との密着性が低くはがれが生じやすい,水分を吸収して膜の特性が劣化しやすい,といった欠点がある。そこで,配線工程にポーラスlow-k膜を導入するには,膜の弾性率や密着性,吸湿性といった特性を詳細に検査・解析し,LSI製造プロセスの信頼性を高める必要がある。






















































