半導体チップのプロセス技術とともに,電子機器の進化を支えてきた技術が,チップとプリント基板の間をつなぐパッケージ技術である。チップが微細化を軸に進化してきたのに対し,パッケージ技術は用途に応じた多様な方向へと進化してきた。ただし,進化の方向性は違ってもパッケージを構成する材料が進化の要となった点は変わりない。今回から3回連続で,パッケージ材料について解説する。今回は,パッケージ技術の概要と主なパッケージ材料について解説する。
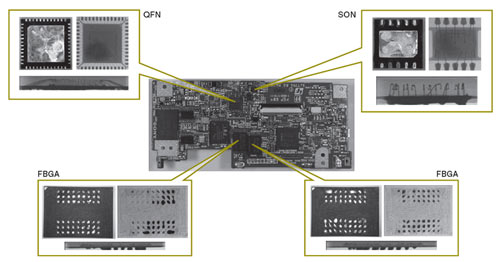
加藤 凡典
エー・アイ・ティ
代表取締役
半導体チップの進化とともに,電子機器の進化を支えてきたのが,パッケージング技術である(図1)。用途に応じて,さまざまな機能や形態を備えるパッケージが開発されてきた。第6回から3回連続で,半導体パッケージの進化を支える材料について解説する。
今回は,パッケージング材料の概要を示す。第7回では,パッケージの基幹材料となるサブストレート(パッケージ基板)と封止樹脂のトレンドを紹介する。第8回では,最終製品には残らない,パッケージングを陰で支える材料として,めっき薬品やバック・グラインド・テープ,ダイシング・テープなどについて紹介する。本連載は,前工程完了後からプリント基板に実装する直前までの工程を対象とし,民生機器や情報機器に向けた主流のパッケージであるプラスチック・パッケージに焦点を当てる。




















































