リソグラフィによるLSIの微細化を支えてきたのがCMP(化学機械研磨)技術である。CMPでデバイス表面を高精度に平坦化することにより,露光に必要な焦点深度を確保できるようになった。CMPの研磨剤として使うスラリーは,平坦化プロセスの制御の決め手となる。LSIへのCu/低誘電率(low-k)膜の導入に伴い,スラリーの砥粒や化学成分の改良によるCMPの低圧・低ダメージ化が重要になってきた。第5回は,CMPの進化を支えるスラリー技術について解説する。
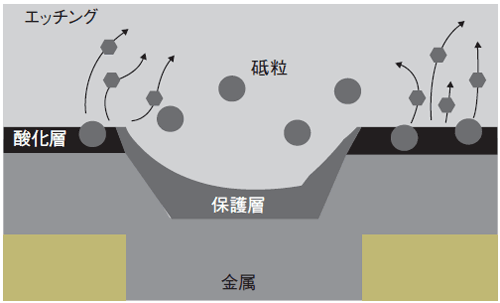
本間 喜夫
日本キャボット・マイクロエレクトロニクス
アジアパシフィックテクノロジセンター
LSI業界では現在,32nm世代のプロセス開発が進んでいる。この微細加工技術の原動力となるのがフォトリソグラフィであり,それを支えるのがCMP(化学機械研磨)である。CMPでデバイス表面を平坦化することにより,微細化のために露光の開口数(NA)を高めることで焦点深度が浅くなっても,正確に露光できるようになった。
微細化の進展に伴い,CMPの研磨精度やデバイス表面の平坦度への要求は厳しくなっている。研磨対象となるデバイス材料の種類も増えている。一方,スラリーやパッドなどの部材に対するコスト低減要求は強まっている。本稿では,CMP技術とそれを支える研磨剤(スラリー)技術について解説する(図1)。