LSI製造の要となるリソグラフィ技術を支えるのが,フォトマスクである。転写パターンの寸法が露光波長を下回ってからは,フォトマスクにおいて,光近接効果補正や超解像技術を駆使することが微細化のカギとなった。ここへ来て液浸露光の量産導入が始まり,フォトマスクには新たな進化が求められている。EUV(extreme ultraviolet)露光やナノインプリントといった次世代リソグラフィ対応のマスク開発も急がれる。連載の第3回は,こうしたフォトマスク技術のトレンドを解説する。
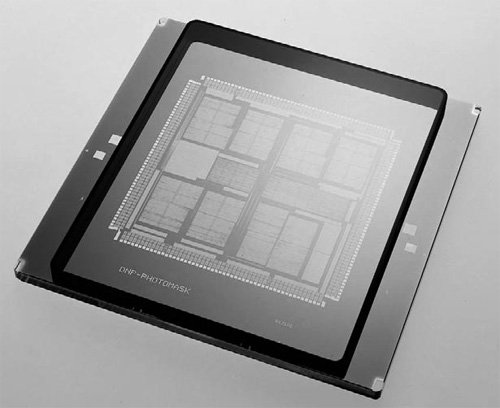
林 直也
大日本印刷
電子デバイス事業部 フェロー
LSI製造プロセスの最も重要な工程といえるのが,微細化と高集積化を支えるリソグラフィである(図1)。そのリソグラフィを通じて,LSIの設計と実デバイスを結び付ける役割を担うのがフォトマスクである。リソグラフィでは,転写パターンの解像度やフォトマスクの位置合わせ精度,スループットのいずれにも高い水準が要求される。これらの要求を満たすカギとなってきたのが,フォトマスク技術である(図2)。
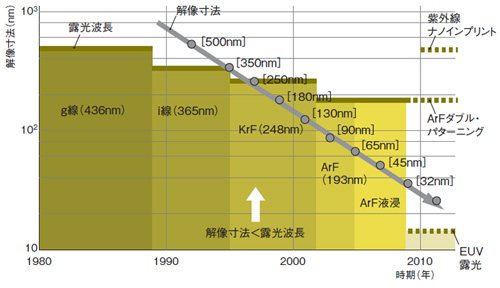

一方,フォトマスクのセット・コストは,微細化に伴って上昇する傾向にある(図3)。このため,セット・コストの増大を抑えつつ,新たな技術課題に対処していく必要がある。

本稿では,次の五つの観点から,フォトマスク技術の現状と今後の課題について解説する。(1)光近接効果補正(OPC:optical proximity correction)と超解像技術(RET:resolution enhancement technology),(2)液浸露光技術への対応,(3)ダブル・パターニング対応,(4)次世代リソグラフィ対応,(5)コスト,である。



















































