第1部<パラダイム・シフト>
微細化に代わる新たな進化軸
TSVによる統合技術が主流に
半導体の新たな進化軸が生まれようとしている。半導体チップを貫通するビア(電極)、いわゆるTSVがその中核である。TSVを組み込んだLSIが、電子機器の革新を支える。

製造技術の微細化や機能の1チップ化から、TSV(through silicon via)を利用したチップ統合技術へ──。機器に搭載される半導体の実現技術が変わりつつある。今後起こるスマートフォンの心臓部の変化は、この方向を先取りした動きといえる。
半導体は1990年代までは、製造技術を微細化すれば低コスト化や高速化、低消費電力化を同時に達成できた。微細化こそが半導体の進歩を牽引してきた。しかし、2000年代初頭ごろから、微細化の神通力が薄れ始め、今では微細化によって得られる効果はすっかり色あせている。「現在でも微細化によって、LSIの集積度は高められる。ただし、性能の向上ペースは以前に比べて鈍っている上、消費電力は逆に増えてしまう」(米国の半導体メーカー)状況にある。
TSVが今後の半導体技術を牽引
閉塞感に覆われる微細化に取って代わり、今後半導体の技術進化を牽引するのが、TSVをベースとしたチップ統合技術である。具体的には、これまで製造技術の微細化により1チップに詰め込んできた機能を、今後は複数のチップに小分けし、それらをパッケージ内で統合する。ここで、チップ間をTSVなどで接続すれば、チップ間をチップ内と同等もしくはそれ以上に高速に接続できる。結果、内蔵するチップを増やすことで、より高集積の半導体を従来と同等以上の性能で実現できる。
第2部<実現技術>
コスト、放熱、テスト
TSVの3大課題を解決へ
TSV技術の普及に向けた課題は、「コスト、放熱、テスト」との指摘が多い。最大の課題であるコストに関しては、TSV加工とチップ接続の両面から低減する必要がある。こうした課題に対し、解決の可能性を秘めた新技術が続々と登場してきた。
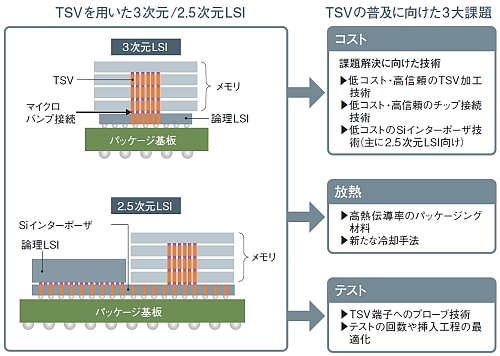
「とにかくコスト。それから放熱とテストだ」──。TSV(through silicon via)を用いた3次元/2.5次元LSIの開発に携わる技術者の多くは、TSV技術の普及に向けた課題をこのように指摘している。
TSVの導入によって新たに発生する製造コストを可能限りゼロに近づけることは最も大きな課題だ。現在量産準備が進められているTSV技術は、まずはスマートフォンやコンピュータ、通信機器などのハイエンド機種向けLSIに適用される。しかし、今後TSVをミドルレンジやローエンドの機種向けに広く普及させるためには、既存のパッケージと同等以下のコストを実現する必要がある。3次元的に積層したチップから効率的に熱を逃がす技術や、チップを積層する前に良品であることを確認するテスト技術も欠かせない。こうした新技術の提案が今、続出している。
第3部<主役うかがう>
ファウンドリーの次はOSAT
TSVの中間工程で飛躍狙う
半導体の後工程受託メーカー(OSAT)が、TSVを機に事業規模を拡大しようと動き出した。狙うのは、TSV導入に伴って新たに生じる中間工程と呼ばれる工程の受注である。これまで培ってきた技術ノウハウと、新技術の両輪でTSV製造の主役を目指す。
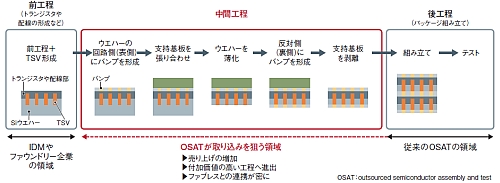
米Qualcomm社などのファブレス半導体企業が勢いを増す中、TSVの導入とともに台頭しそうなのが、組み立てやテストを担当するOSAT(outsourced semiconductor assembly and test)と呼ばれる半導体の後工程受託メーカーである。チップのトランジスタや配線を形成する前工程のファウンドリー企業が、微細化の進展に伴い存在感を高めたのと同様に、今後はOSATがTSVをきっかけに力をつけていきそうだ。
TSVを通じて顧客と近密に
OSATが狙うのは、TSVの導入によって前工程(フロントエンド)と後工程(バックエンド)の間に新たに加わる「中間工程(ミッドエンド)」である。中間工程には、支持基板を張り合わせてウエハーを薄化したり、バンプを形成したりするTSV向けの新たな技術が含まれる。
OSATは、こうしたTSV向けの技術開発や設備投資を活発化させている。これまでOSATは、TSVに対応するために技術の準備を着々と進めてきた。例えば、メモリ・チップの積層で薄いウエハーの取り扱いの経験を積み、チップの回路面をパッケージ基板に直接接続するフリップチップで微細な接合のノウハウを身に付けてきた。これらの経験を生かして、2012年にもTSVを導入したSiインターポーザを用いる2.5次元LSIの量産対応を開始し、続いて2013~2014年にメモリの積層やロジックとメモリを重ねる3次元LSIの量産へと移行する計画である。
OSATには、従来の組み立てやテストの工程に加えて、付加価値の高いTSVの中間工程を担うことで、事業規模を拡大したいという思惑がある。OSATの中でも特に、大手企業が積極的に動いている。それは、「TSVの導入は大手のOSATにとって有利に働く」(半導体業界の関係者)からである。



















































