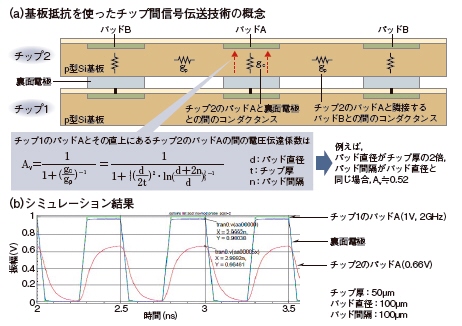
3次元に積層したLSIチップ間を接続するための新たな信号伝送技術が登場した。薄型化したSi基板そのものを伝送媒体として使う技術で,国内ベンチャー企業のソーバスメモリが開発した。既存の半導体プロセスでほぼ実現できるため,Si基板に穴を開けて電極を埋め込むTSV(through silicon via)技術などに比べて低コストで3次元実装が可能になるという。民生機器向けSiP(system in package)におけるワイヤ・ボンディングの置き換えなどを目指す。
L,CでできるならRでも
ワイヤ・ボンディングの代替を狙うチップ間伝送技術は,TSVのほかにも,いくつか提案されている。代表的な技術は2種類ある。一つは,LSIの配線で作ったコイルの磁界結合を利用する技術である。多数の積層チップ間の伝送が可能だが,現時点では実用化されていない。もう一つは,容量結合を用いた伝送技術である。回路構造を簡略化しやすく微細化に向くものの,積層可能なチップ数が2個に限られる。



















































